
新闻中心
News Center 更新时间:2026-02-03
更新时间:2026-02-03 点击次数:190
点击次数:190
在材料检测与研发中,科研人员常常面临一个抉择:用扫描电镜(SEM)看清样品形貌后,若想进一步分析其成分、缺陷或发光特性,往往需要切换模式、更换探测器,甚至动用另一台专用设备。这个过程耗时耗力,还可能丢失关键的原位关联信息。
日本电子(JEOL)发布的应用文档,展示了一款低真空混合二次电子探测器(LHSED)如何为解决这一痛点提供新思路。它并非要取代任何专用分析设备,而是通过硬件创新,让一台常规的扫描电镜在完成本职高分辨率形貌成像的同时,近期我司新推出升级了额外具备了快速获取材料发光特性信息的能力。
技术核心:从“单一采集"到“光电双路"的集成
传统扫描电镜的探测器各司其职:二次电子(SE)探测器负责形貌,背散射电子(BSE)探测器负责成分衬度,而要进行阴极发光(CL)分析则需要复杂的光学系统。LHSED的创新在于,它在一个探测器中集成了两套信号采集通路。
1. 电子信号通路:继承并优化了低真空下的气体放大技术,用于采集高质量的二次电子图像,尤其改善了低真空模式下的实时成像速度和信噪比。
2. 光信号通路:新增了直接采集样品受电子束激发所产生光信号(即阴极发光)的功能。

LHSED信号采集原理
LHSED的三种模式表

用户只需在软件界面切换“LSED-P"(形貌优先)或“PD"(发光分析)模式,即可在同一位置、同一时间点,先后获得表面的精细形貌图和反映材料内部缺陷、杂质或相分布的发光对比图。这种设计避免了样品移动和重新寻找视野,保证了两种信息严格的空间对应关系。
价值体现:不是替代,而是效率与洞察力的提升
根据应用文档中的案例,这项集成技术在实际工作中带来了可验证的效率提升与功能补充。
1. 成像体验优化,操作更流畅
文档通过对比名片表面的图像直观展示,在低真空模式下,新探测器的LSED-P模式获得的实时图像更平滑、细节更清晰。这使得用户在观察不导电样品时,能更快地对焦和导航,将操作时间转化为分析时间。
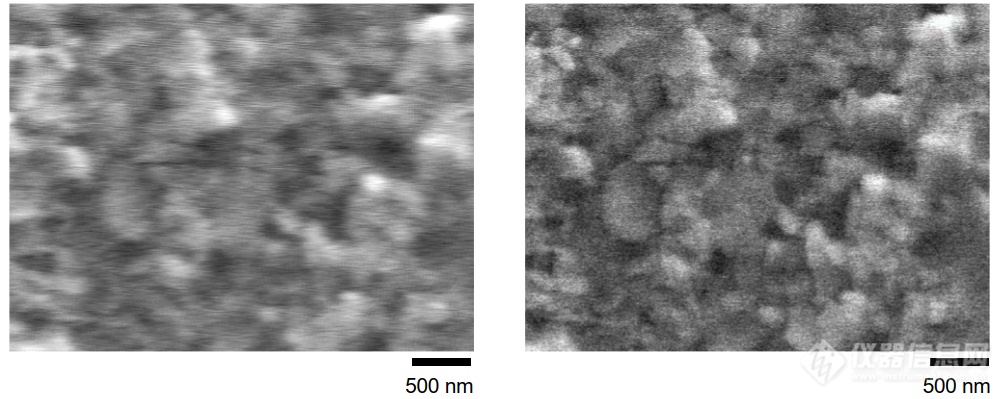
名片表面的低真空二次电子图像。加速电压5kV,放大倍率x30,000,扫描时间0.15秒;传统低真空二次电子探测器(左),低真空混合二次电子探测器(右,LSED-P模式)
2. 快速筛查定位,引导深入分析
对于混合样品中发光特性不同的组分,PD模式能实现快速可视化筛查。例如,在锌粉中定位发光的氧化锌夹杂物,或在LED芯片断裂面快速定位发光区域。这相当于为研究人员提供了一个“材料特性指示器",能快速锁定感兴趣区域,从而更有目的地使用能谱仪(EDS)或专业CL系统进行后续定量分析,提升了整体研究的工作流效率。

Zn颗粒及其中ZnO颗粒的SEM图像和元素面分布图像。加速电压:10kV,放大倍率:x3,000

Zn颗粒和ZnO颗粒的拼接图像。加速电压5kV,单视野放大倍率x30,000,观察范围0.852x0.314mm
3. 缺陷直观呈现,提供质量控制新视角
在氮化镓(GaN)半导体衬底的检测中,文档显示PD模式可以清晰揭示传统电子图像难以显现的晶体位错网络。结合图像处理软件,可对这些缺陷进行快速统计和面积估算。这为半导体工业的工艺监控和失效分析提供了一个快速、直观的辅助工具。

(a)晶体中的滑移变形,(b)位错

PD图像与图像分析软件的结合可用于GaN的位错面积和位错密度测试
小结:扫描电镜功能的实用拓展
日本电子的这项LHSED技术,其核心价值在于通过探测器层面的集成创新,务实拓展了扫描电镜的平台功能。
它使得形貌观察与材料发光特性分析这两个原本分离的工作步骤,得以在单一设备上无缝衔接。这尤其适用于需要将微观结构与材料性能进行快速关联的领域,如半导体失效分析、新型光电材料研发、地质矿物鉴定等。
对于用户而言,它意味着在不解破真空、不更换样品的前提下,就能获得更丰富、更具关联性的多维信息,从而做出更高效、更准确的分析决策。这标志着扫描电镜正从一个的成像工具,向一个功能更集成、信息更立体的综合分析平台演进。